高温烧成类型导电膏
CuAgTi基
导电膏(Cu系列)
产品详情
特点
- 通过在表层涂覆铜膏,能够形成厚度达 0.3mm 及以上的超厚膜层。
- 它不含铅(Pb)和镉(Cd)等对环境有害的物质。
- 它具有出色的耐热性、抗冲击性和可靠性。
- 金属膜与基板之间形成了牢固的化学键,对于氮化硅(Si₃N₄)和氮化铝(AlN)基板展现出极佳的粘附性能。
结构
-
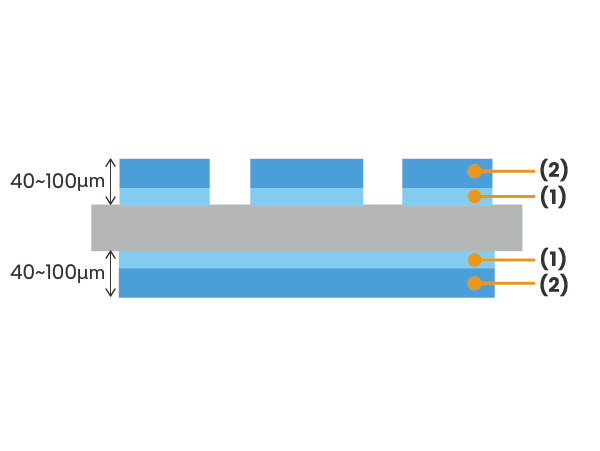
薄膜厚度小于 100μm
■工艺流程
(1) 印刷粘结层(AS112)
(2) 印刷粘结层的上层 (DC014GL)
(3) 烧制,例如在 850℃、氮气条件下进行 -
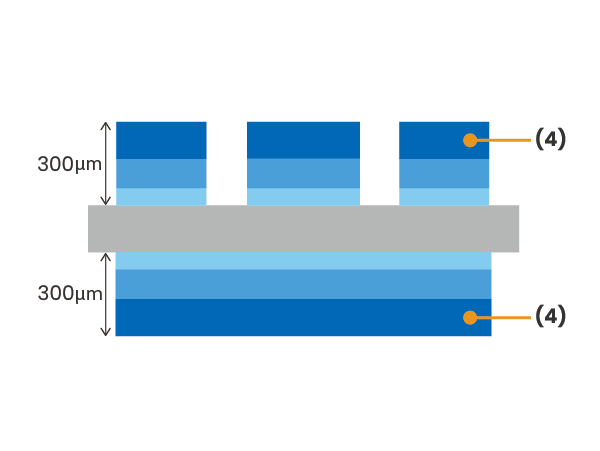
膜层厚度为 100μm 及以上
对于膜层厚度为 100μm 及以上的情况,需添加以下工艺流程
■工艺流程
(4) 印刷增厚层(GL39)
(5) 烧制,例如在 800℃、氮气条件下进行
-

烧制后的基材图像
使用活性金属膏作为粘结层的已烧制铜浆厚膜(50μm)基板。
(1) SiN
(2) 铜 -
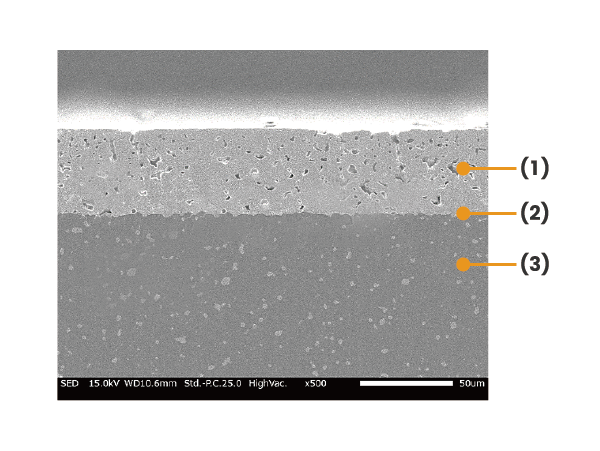
横截面扫描电子显微镜图像
烧制后的基板图像
(1) 铜膜
(2) 含活性金属的粘结层(结构式:Ti₅Si₃)
(3) SiN 基板
应用示例
-
- Ceramic heat dissipation circuit packages for power devices
- Ceramic circuit boards and ceramic packages that require high reliability
规格
| 类型 | 膜厚 | 应用 | 特性 | 导电成分 | 粘附强度 (N/2mm□) | 推荐的烧结条件 | 涂覆方法 | 基材 | |
|---|---|---|---|---|---|---|---|---|---|
| 100μm< | 100μm≧ | ||||||||
| AS112 | ○ | ○ | 厚膜导体布线,电极形成(与陶瓷基板的结合层) | 高结合强度,高热可靠性 | Ag, Cu, Ti |
≧30 |
850 °C 10 分钟,在氮气中 |
丝网印刷 | Al₂O₃, AlN, Si₃N₄ |
| DC014GL | ○ | ○ | 厚膜导体布线,电极形成 | 高表面平滑度,单次印刷可形成较大的膜厚度 | Cu | - | 850 °C 10 分钟,在氮气中 | 丝网印刷 | Al₂O₃, AlN, Si₃N₄ |
| GL39 | - | ○ | 超厚膜导线布线,电极形成(用于多层厚化) | 单次印刷可形成较大的膜厚 | Cu | - | 800 °C 10 分钟,在氮气中 | 丝网印刷 | Al₂O₃, AlN, Si₃N₄ |
注意事项
- 应在氮气环境中烧制。
- 请查阅每个产品的材料安全数据表(SDS)。
备注
如果您没有备用的氮气炉,我们可以代您进行烧制。


